半導體製程類
- 更新日期:113-01-30
- 發布單位:儀器資源中心
[光復校區] 多腔式磁控電漿薄膜系統 Sputter C
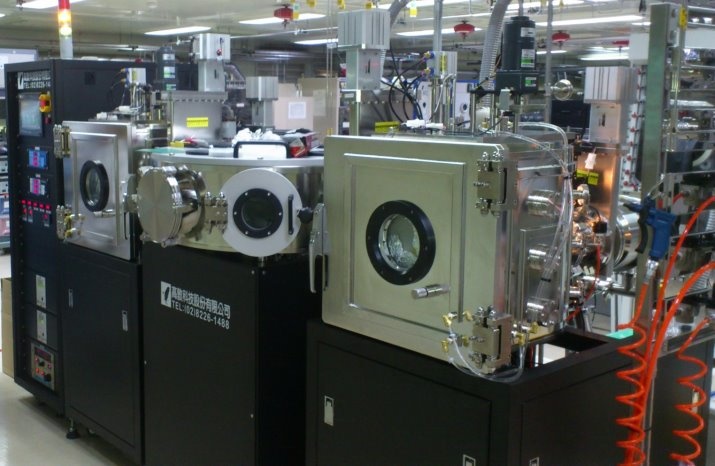
- KD-Sputter-Load luck
- 英文簡稱:Sputter C
- 廠牌:高敦
- 型號:Sputter – Load Luck
- 儀器專家:林鴻志 教授
- 分機 54193
- 儀器操作技術員:劉秉哲 同學
- 分機 54227
- 信箱 m4315183082.ee07@nycu.edu.tw
- 儀器位置:奈米中心三樓304室(無塵室)
儀器廠牌、型號、購置年限
廠牌:高敦
型號:Sputter – Load Luck
購置年限:100年11月
重要規格
廠牌:高敦
型號:Sputter – Load Luck
購置年限:100年11月
重要規格
- 人機界面
- 2支6吋濺鍍陰極
- 每次可放1片WAFER (6吋or4吋皆可,4吋須貼在載片上)
- POWER: DC:1500W*1台與RF:1000W*1台
- 氣體:MFC for Ar與O2
- 抽氣系統:RP + Turbo Pump
- 基板載台轉速5rpm,可調控
- 可升溫最高300oC
- 靶材種類:ZnO與IGZO
- 開放ZnO、IGZO薄膜濺鍍。
- 標準製程參數
- 瓦數:100W
- Ar=50sccm
- O2=0~1sccm
- 製程壓力:5mtorr
- 製程溫度:室溫
- 以上條件為較佳之薄膜條件,已藉由TFT製作及特性量測證實。
- 若需要使用非標準製程參數沉積薄膜,請提早來信或來電給操作技術員,需做鍍率測試。
- 鍍膜限制
- O2流量 ≦5sccm
- 厚度:O2=0sccm 厚度≦500nm
- O2=1sccm 厚度≦150nm
- O2>1sccm 厚度≦100nm
- 濺鍍瓦數≦200W (太高反射率易過大造成機台alarm)
- 沉積溫度<200oC (太高反射率易過大造成機台alarm)
- 沉積壓力5~20mtorr
開放時間
- 週一至週五:13:00~17:00進行委託操作
- 夜間及週六、日:不開放
系統開放等級
- 一般上班時段:D級
- 夜間及假日時段:D級
系統開放等級說明
- A級:開放給需要使用之學生,經訓練考核後可自行操作。
- B級:每位教授指派一位學生申請訓練,該教授之其他學生需由接受訓練的學生代為操作,若有教授使用該儀器之學生過多者,可向儀器負責人申請增加接受訓練學生人數。
- C級:由儀器負責人選定教授推薦之學生若干人接受訓練,經考核後可自行操作儀器並得負責委託服務工作。
- D級:由本實驗室之技術人員接受委託服務,不開放使用。
| 收費標準\單位 | 學術單位 非儲金/儲金會員 |
廠商及研究單位 非儲金/儲金會員 |
|---|---|---|
| 委託操作 (本機不開放自行操作) |
開機費:1500 使用費:1000/750(每小時) |
開機費:3000 使用費:2000/1500(每小時) |
備註:學術單位指各大專院校。
管理辦法及使用辦法
- 本機台僅開放委託ZnO、IGZO兩種金屬氧化物薄膜沉積,沉積條件請依照服務項目之規定。
- 每個月固定進行一次鍍率測試以及機台保養。
- 為維持沉積薄膜環境以及濺鍍薄膜品質,本機台嚴禁含銅試片或進過可鍍銅機台之試片以及具有揮發性有機物之試片,請務必注意。
儀器訓練操作申請須知
不開放訓練
儀器操作預約:申請委託操作之方法
不開放訓練
儀器操作預約:申請委託操作之方法
- 以電話或E-mail與儀器聯絡人接洽委託操作事宜。
- 請詳細描述試片結構、欲鍍材料及沉積條件等需求。
- 申請人於預約時段至少一星期前將試片送交儀器聯絡人,申請人委託前請與儀器聯絡人洽談細節。
- 每個委託時段僅限鍍一片六吋晶圓,四吋以下及破片請黏貼於六吋載片上再進行鍍膜。
- 儀器聯絡人得視需要可要求申請人在現場共同進行實驗。
相關圖片:
相關連結:












 EN
EN

